[Posting : 2025.08.19] 2025년 HBM 패키징 경쟁은 적층 방식의 진화가 핵심입니다. SK hynix는 MR-MUF 공정으로 12-Hi를 안정적으로 양산하며 열경로·수율에서 우위를 확보했고, 16-Hi 확장까지 준비 중입니다. 삼성전자는 TC-NCF 기반의 정밀 적층으로 12-Hi를 8-Hi와 동일 높이로 구현하며 기구적 호환성을 강조하고, I-Cube/H-Cube 플랫폼으로 로직 통합을 차별화합니다. 마이크론은 전력 효율성을 무기로 HBM3E 시장에 도전하고 있으며, 엔비디아 H200 채택으로 입지를 다졌습니다. 차세대 HBM4에서는 2,048-bit 인터페이스와 2TB/s 대역폭을 구현하기 위해 하이브리드 본딩이 필수 기술로 부상합니다. 현세대는 MR-MUF와 TC-NCF가 병존하되, 향후는 하이브리드 본딩이 표준으로 자리잡을 전망입니다.
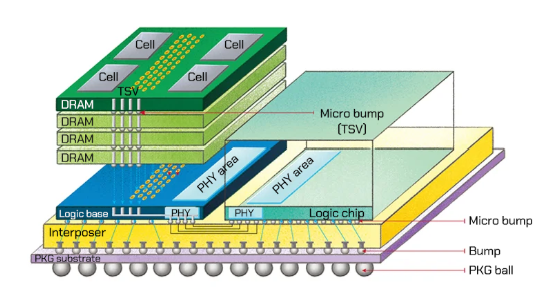
HBM 패키지 적층 방식 분석: MR-MUF vs. TC-NCF vs. 하이브리드 본딩, 그리고 경쟁사별 패키징 장·단점
한눈에 보는 요약
HBM 스택은 기본적으로 TSV(Through-Silicon Via) 로 연결된 DRAM 다이를 수직 적층해 하나의 “큐브”를 만들고, 이것을 GPU/ASIC과 2.5D(실리콘/유기 인터포저) 혹은 팬아웃/브릿지 기술로 통합합니다. 적층 공정의 핵심은 마이크로범프+언더필 기반의 두 가지 주류 방법(TC-NCF vs MR-MUF)과 차세대 하이브리드 본딩(Cu-Cu, 범프리스) 입니다.
- MR-MUF: 생산성·열경로 우수, 더 많은 더미(thermal) 범프를 허용해 고층(12-Hi/16-Hi)에서 유리.
- TC-NCF: 정밀 얼라인·높이 제어에 강점. 삼성의 12-Hi HBM3E는 8-Hi와 동일한 높이 스펙을 유지.
- 하이브리드 본딩: HBM4(2,048-bit, 스택당 ~2.0 TB/s) 세대에서 본격 채택 전망. 열·전기적 이점과 스택 높이(두께) 축소가 핵심.
- 로직과의 통합은 TSMC CoWoS-S/L/R(대형 인터포저·RDL 유기 인터포저)와 삼성 I-Cube/H-Cube(실리콘·임베디드 브릿지) 등 플랫폼이 주도.
1) HBM 적층의 기초: TSV + 마이크로범프 + 언더필
- TSV 형성: DRAM 웨이퍼에 구멍을 뚫고 금속으로 메움.
- 마이크로범프 접합: 다이 간 전기적/기계적 연결.
- 언더필: 기계적 지지·열전달·응력 분산.
- 스택 마감/그라인딩/캐핑 후 인터포저/패키지에 실장.
이 공정에서 언더필 적용과 접합 방식이 생산성·열·수율을 좌우합니다.
2) TC-NCF vs. MR-MUF: 두 라이벌 공정의 기술 차이
TC-NCF(Thermal Compression + Non-Conductive Film)
- 프로세스: 각 다이를 순차적으로 올리고 비전도성 필름(NCF) 을 사이에 개재, 열·압력으로 접합.
- 장점
- 스택 높이 및 단차 제어에 유리 → 모듈화·기구 호환성 확보. 삼성 12-Hi HBM3E가 8-Hi와 동일 높이를 달성.
- 필름 기반이어서 갭 충전 품질이 안정적(공극 억제), 공정 노하우 축적.
- 단점
- 순차 본딩으로 처리량이 낮고, 고층으로 갈수록 열·응력 경로 확보가 어려움.
- 열 더미 범프 수에 제약 → 고발열 스택에서 온도 관리 한계가 발생.
MR-MUF(Mass-Reflow + Molded Underfill)
- 프로세스: 적층 후 몰드형 언더필(EMC 등) 을 충진·경화하며 전체를 일괄 리플로우.
- 장점
- 일괄(매스) 공정으로 처리량↑, 열경로(더미 범프)↑ → 고층·고발열에서 온도/균일성 유리.
- 전도성 필러 적용 용이, 스택 열전도 개선 보고.
- 단점
- 몰드 재료·경화 수축·응력 설계가 어려워 와파지·균일도 관리 난이도 상승.
- 초기 세팅에 공정 최적화 시간 필요.
업계 분석에 따르면 MR-MUF는 TC-NCF 대비 열 성능·생산성·수율에서 우위를 보였고, 이로 인해 특정 업체가 시장 리더십을 확보하는 데 기여했습니다.
3) 차세대: 하이브리드 본딩(Cu-to-Cu, 범프리스)
하이브리드 본딩은 마이크로범프/언더필 없이 다이 표면의 구리-구리 직접 접합(동시에 절연층 결합)을 사용합니다.
- 장점
- I/O 피치 대폭 축소 → 더 많은 채널/더 짧은 경로(신호 지연·전력↓).
- 열경로 개선·스택 높이 ~15%+ 감소 보고 → 고층·고전력 HBM에서 온도 이점.
- HBM4와의 연계
- HBM4 인터페이스 2,048-bit, 스택당 ~2.048 TB/s 목표. 배선 폭/밀도 증가에 따라 하이브리드 본딩 채택 가속.
- 2025~2026 시점부터 주요 벤더들이 채택을 공식화/시사. 중장기적으로 HBM 전반에 보편화 전망.
4) 로직과의 통합: CoWoS, I-Cube/H-Cube 등 플랫폼
- TSMC CoWoS®
- CoWoS-S: 대형 실리콘 인터포저(최대 ~3.3× 레티클, ~2,700 mm²).
- CoWoS-L/R: 더 대형 패키지 수용을 위해 유기 RDL 인터포저/하이브리드 선택지 제공.
- 신세대 GPU(예: Blackwell) 에서 CoWoS-L 확대 흐름.
- CoWoS-R: 유기 기반으로 열·CTE 스트레스 완충에 유리하다는 평가.
- 삼성 I-Cube™ / H-Cube™
- I-CubeS/E: 실리콘 vs 임베디드 브릿지(E-SiB) 기반 2.5D 패키지. 대형 로직+다수 HBM 통합 지향.
- H-Cube: 하이브리드 기판(파인-피치 + HDI) 융합으로 대면적 2.5D 구현(6~12 HBM 구성 로드맵).
포인트: 메모리 스택 자체의 적층 방식(MR-MUF/TC-NCF/HyB)과, 로직과 시스템 통합 방식(CoWoS/I-Cube/H-Cube)은 구분해야 합니다. 전자는 메모리 벤더 공정, 후자는 파운드리/OSAT 생태계의 역량입니다.
5) 경쟁사별 패키징 전략과 장·단점
SK hynix
- 전략/기술
- MR-MUF를 고도화(Advanced MR-MUF). 더 많은 열 더미 범프와 전도성 필러로 열·신뢰성 개선. 12-Hi 및 3E/3E+ 세대 리더십 견인.
- 장점
- 생산성·수율·열관리 우위 보고 → 고층(12-Hi/16-Hi), 고속 핀에서 유리.
- 대형 AI 고객향 공급 이력과 공정 성숙도.
- 리스크/과제
- MUF 재료/응력 설계 최적화 지속 필요, HBM4 하이브리드 본딩 전환 타이밍 전략 중요.
Samsung Electronics (Memory & Foundry)
- 전략/기술
- 메모리 적층에서 TC-NCF를 주력으로 발전시켜 12-Hi HBM3E 높이 동등화 달성. 동시에 MR-MUF 채택 검토/도입 움직임도 보도됨. 시스템 통합은 I-Cube/H-Cube로 대형 인터포저 대안 제공.
- 장점
- 높이/기구 호환성·정밀 제어에 강점(TC-NCF). 자체 파운드리 패키지(I-Cube/H-Cube)로 수직 통합 옵션.
- 리스크/과제
- 고층/고발열 대응에서 열경로 확보가 관건(더미 범프 제약). MR-MUF·하이브리드 본딩으로의 전환 속도·수율 안정화가 경쟁포인트.
Micron Technology
- 전략/기술
- HBM3E에서 전력효율 강조(자사 수치 기준 경쟁사 대비 ~30% 저전력)와 최신 공정(1β) 기반. 적층은 TC-NCF 로드맵 중심에서 핵심 공정·장비 개선을 병행.
- 장점
- 전력 효율성 및 신뢰성 개선 어필, AI 가속기(예: H200 등) 채택 사례 확대.
- 리스크/과제
- 고층화·발열 급증 환경에서 열·처리량 측면의 공정 한계 보완 필요. 하이브리드 본딩 이행 로드맵의 속도·성숙도가 관건.
6) 공정별 기술 지표 비교(요약)
| 항목 | TC-NCF | MR-MUF | 하이브리드 본딩 (Cu-Cu) |
| 접합 방식 | 순차 열압착 + NCF | 일괄 리플로우 + 몰드 언더필 | 범프리스 Cu-Cu 직접결합 |
| 처리량(Throughput) | 중간(순차) | 높음(일괄) | 중간(정밀 표면 준비) |
| 열 경로/더미 범프 | 제약 有 | 더미 범프 수↑/열경로↑ | 범프 제거로 열저항↓ |
| 스택 높이/와파지 | 높이 제어 용이 | 응력·수축 설계 필요 | 스택 두께↓ (~15%+) 보고 |
| 고층(12-Hi/16-Hi) 확장 | 공정 최적화 필요 | 상대적 유리 | 가장 유리(장기) |
| 성숙도 | 매우 성숙 | 성숙(최적화 필요) | 부상/확산 단계 |
강조점: HBM4/5로 갈수록 하이브리드 본딩의 전기·열·밀도상의 이점이 결정적이 되며, 당분간은 MR-MUF(현 세대) 와 HyB(차세대) 가 공존할 가능성이 큽니다.
7) 인터포저/플랫폼 선택이 주는 의미
- CoWoS-S(대형 실리콘) ↔ CoWoS-L/R(유기/RDL 확장)은 대면적·다중 HBM 통합에서 비용·열·신뢰성의 트레이드오프를 제공합니다. CoWoS-R은 유기 재질의 응력 완충 이점이 보고됩니다.
- I-Cube/H-Cube는 임베디드 브릿지/하이브리드 기판으로 대면적 집적을 구현, HBM 8~12개 이상 구성이 가능한 로드맵을 제시합니다.
8) 실무 체크리스트(구매/설계자 관점)
- 전력밀도(스택당 W) & 채널 수: 12-Hi/16-Hi, 핀속 증가 시 열경로·더미 범프 전략이 핵심.
- 처리량·리드타임: 대량 배치가 필요한 AI 가속기(수천~수만 스택)에서는 MR-MUF 계열이 일정 안정성에 유리.
- 기구 스펙/모듈 높이: 시스템 제약이 크면 TC-NCF의 높이 제어 이점 고려.
- 차세대 로드맵: HBM4(2,048-bit) 및 하이브리드 본딩 채택 계획을 벤더별로 확인(수율·성숙도·장비 체인 포함).
- 플랫폼 정합성: CoWoS-S/L/R vs I-Cube/H-Cube 중 열/CTE/면적 최적 조합 선택.
9) FAQ
Q1. HBM4에서 왜 하이브리드 본딩이 중요해지나요?
A. 버스 폭 2배(2,048-bit) 및 핀속·용량 확대로 I/O 밀도와 전력/열 스펙이 급격히 증가합니다. Cu-Cu 직접결합은 저저항·저인덕턴스·저열저항을 동시에 달성하며, 스택 높이도 줄여 열 누적을 낮춥니다.
Q2. “MR-MUF가 무조건 낫다”가 정답인가요?
A. 세대/제품 목표치에 따라 다릅니다. MR-MUF는 처리량·열경로 면에서 강하지만, TC-NCF는 높이 제어·정밀도에 장점이 있습니다. 또한 HBM4 이후에는 하이브리드 본딩이 궁극적 스케일링 경로로 부상합니다.
Q3. 로직 패키지(CoWoS/I-Cube)가 메모리 적층 성능에도 영향이 있나요?
A. 네. 열확산 경로·CTE 매칭·전기적 배선 길이는 시스템 성능/신뢰성을 좌우합니다. 예를 들어 CoWoS-L/R 같은 유기/RDL 옵션은 대형화와 응력 완충에 유리합니다.
10) 결론: “현세대는 MR-MUF, 차세대는 HyB”…TC-NCF는 정밀·높이에서 니치 강점
- 현세대(HBM3E): MR-MUF가 열·생산성·수율에서 강세를 보이며 리더십을 뒷받침. 경쟁사들은 TC-NCF 정밀 제어와 기구 스펙에서 차별화, 동시에 MR-MUF 도입과 하이브리드 본딩 준비를 병행 중.
- 차세대(HBM4): 2,048-bit/고전력 시대에 하이브리드 본딩이 대세로 이동. 벤더별 전환 속도·수율 안정화가 승부처. 시스템 측면에서는 CoWoS-L/R 및 I-Cube/H-Cube 등 대면적·다중 HBM 통합 역량이 병행해 중요해집니다.
'반도체 > General' 카테고리의 다른 글
| [반도체] HBM3E 전성기, HBM4로 향하는 AI 메모리 전쟁!! (0) | 2025.08.19 |
|---|---|
| [반도체] 2025 HBM 시장 : SK hynix 독주 속 Micron 급부상…삼성은 반등 모색 (2) | 2025.08.18 |
| [반도체] AI 데이터 센터의 혁신 : Silicon photonics를 이용한 Co Packaged Optics (CPO) (0) | 2025.05.19 |
| [반도체] 2025 미국발 관세전쟁 이후에도 계속되는 화웨이 제재: Ascend AI 프로세서와 미중 기술 패권 전쟁 (1) | 2025.05.19 |
| [반도체]중국이 "희토류"를 이용한 미국과의 정치 압박 작전!! (1) | 2025.04.13 |



